先進的 2.5D / 3D-IC 系統由多塊裸晶、中介層、封裝層和連接基板組成,這使得耦合效應更加具有挑戰性。多晶體異質整合(HI)的出現,將不同的製程技術和電氣特性整合在一起,需要依靠超越現有的設計工具和流程與更強設計和驗證能力。從系統封裝(SIP)到帶有中介層的先進封裝的 2.5D-IC 以及真正的 3D 電路,既有訊號網絡又有電源供應網絡的新興連接架構急需具有超大的數據容量、高度可擴展計算能力與具創新技術的電子設計自動化(EDA) 解決方案。
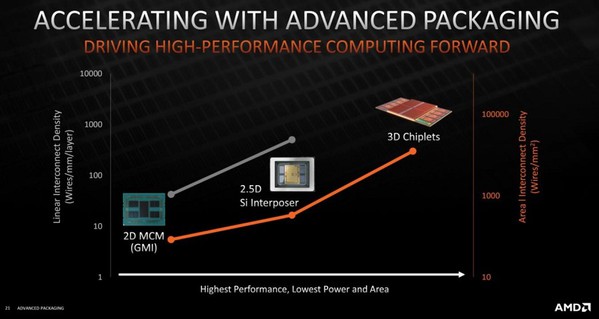
| 圖一 : 2.5D 和 3D-IC 可實現持續擴展、更高性能和更低功耗。 |
|
ACCELERATING WITH ADVANCED PACKAGING
多物理的挑戰
...
...
| 使用者別 |
新聞閱讀限制 |
文章閱讀限制 |
出版品優惠 |
| 一般使用者 |
10則/每30天 |
0則/每30天 |
付費下載 |
| VIP會員 |
無限制 |
25則/每30天 |
付費下載 |

